半导体QFN的IC 引线框架表面处理粗糙度分析
铜基镀银 IC 引线框架是半导体塑封器件的核心材料,其表面粗糙度直接影响与塑封料的机械互锁结合力,进而决定 QFN 塑封器件的抗水汽分层能力和 MSL 湿敏试验可靠性。为满足 QFN 器件向大尺寸、高湿敏等级发展的需求,本文以有机酸超粗化结合低电流镀银工艺为研究对象,通过光子湾科技共聚焦显微镜对铜基材及银镀层的表面粗糙度 Sa 值进行精准表征,分析粗化时间、电镀电流对表面粗糙度的影响规律。
一、表面粗糙度Sa值的表征方法

QFN用铜基镀银IC引线框架超粗化电镀工艺
本文采用有机酸粗化液对裸铜引线框架进行处理,主要成分为醋酸铜、氯化铵、甲酸钠、冰醋酸、甲酸及添加剂。粗化后经3.5%盐酸清洗去除表面不溶性腐蚀产物,恢复金属光泽。随后在不同电流条件下进行镀银处理。
表面粗糙度Sa值(即表面算术平均高度)是评价微观形貌的重要参数。本研究使用共聚焦显微镜对不同粗化时间和电镀条件下的样品进行测量,结合扫描电镜观察表面形貌,系统分析工艺参数对粗糙度的影响规律。
二、粗化时间对表面粗糙度Sa值的影响
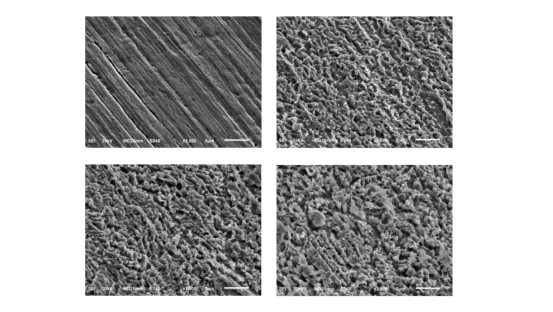
a.未粗化铜面 3500x 表面形貌;b.粗化 1.5 微米铜面 3500x 表面形貌;c.粗化 2 微米铜面 3500x 表面形貌;d.粗化 2.5 微米铜面 3500x 表面形貌。
在相同粗化液浓度和工艺条件下,对裸铜引线框架分别处理15s、30s和45s,使用共聚焦显微镜测量其表面粗糙度Sa值。结果显示,未经粗化的铜表面呈现轧制纤维状织构,Sa值约为110~130nm;粗化15s后,Sa值上升至275~301nm,表面织构消失,出现明显凹凸形貌;粗化30s后,Sa值进一步增加至330~358nm;粗化45s后,Sa值达到380~405nm。
从数据可以看出,粗化初期反应速率较快,随着时间延长,粗糙度增幅趋缓。共聚焦显微镜的测量结果与SEM图像吻合良好,说明粗化时间与粗糙度呈正相关关系,且可通过控制粗化时间实现表面形貌的调控。
三、电镀电流对镀层表面粗糙度的影响

不同电流下粗化框架和未粗化框架镀层粗糙度对比
在粗化处理基础上,分别采用15A、30A和70A电流进行镀银,使用共聚焦显微镜测量镀层表面粗糙度Sa值。结果显示,相同粗化条件下,电流越小,镀层表面结晶颗粒越大,粗糙度越高。以粗化2.5μm的框架为例,15A电流下镀层Sa值为310~337nm,30A下降至275~290nm,70A时进一步降至220~246nm。
对于未粗化框架,15A电流下镀层Sa值为210~234nm,30A为135~170nm,70A仅为110~140nm。共聚焦显微镜的数据表明,粗化框架在相同电流下具有更高的镀层粗糙度,且小电流有利于形成粗大晶粒,提升表面微观起伏。
四、粗糙度对抗分层性能的影响
为验证粗糙度提升对器件可靠性的影响,选用QFN64封装形式,分别采用粗化+15A电镀工艺与未粗化+15A电镀工艺进行对比。经MSL一级湿敏试验后,超声扫描结果显示,未粗化样品出现载体分层,而粗化样品无分层现象。
这表明,通过有机酸粗化与小电流镀银工艺,可显著提升引线框架表面粗糙度,增强与塑封料的结合力,从而有效抵抗水汽侵入和热应力引起的分层失效。共聚焦显微镜在此过程中的粗糙度表征为工艺优化提供了关键数据支持。
综上,通过共聚焦显微镜对QFN 铜基镀银 IC 引线框架的精准表征,明确了有机酸粗化时间和镀银电流对表面粗糙度 Sa 值的调控规律:粗化时间越长,铜基材表面粗糙度Sa值越高,初期反应速率最快,后期趋于平稳。电镀电流越小,镀层结晶越粗大,表面粗糙度越高;粗化框架在相同电流下具有更高的镀层粗糙度。表明有机酸粗化与小电流镀银工艺可满足QFN封装MSL一级试验要求。
光子湾3D共聚焦显微镜
光子湾3D共聚焦显微镜是一款用于对各种精密器件及材料表面,可应对多样化测量场景,能够快速高效完成亚微米级形貌和表面粗糙度的精准测量任务,提供值得信赖的高质量数据。

超宽视野范围,高精细彩色图像观察
提供粗糙度、几何轮廓、结构、频率、功能等五大分析技术
采用针孔共聚焦光学系统,高稳定性结构设计
提供调整位置、纠正、滤波、提取四大模块的数据处理功能
光子湾共聚焦显微镜以原位观察与三维成像能力,为精密测量提供表征技术支撑,助力从表面粗糙度与性能分析的精准把控,成为推动多领域技术升级的重要光学测量工具。