硅基光波导表面粗糙度导致光损耗的研究
在现代光通信与光子集成领域,硅基光波导因其优异的性能已成为核心元件。然而,由侧壁粗糙度引起的光传输损耗,严重限制了其应用性能的进一步提升。因此,对光波导表面粗糙度的精确测量与分析,成为优化器件设计、提升性能的关键所在。下文,光子湾科技将详解共聚焦显微镜(CLSM)在测量硅基波导侧壁粗糙度的应用,并分析其粗糙度与光传输损耗之间的关联。
一、共聚焦显微镜的测量原理
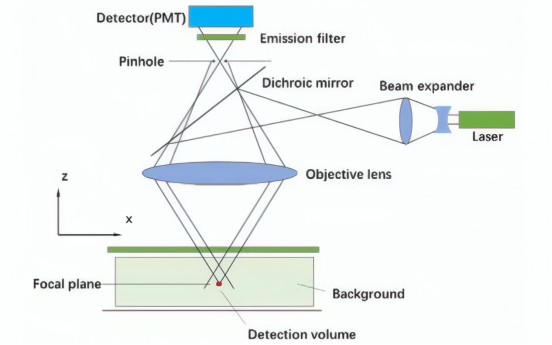
共聚焦显微镜系统的光学成像原理
共聚焦显微镜的核心优势在于非接触式成像与三维精准表征。其工作原理为:光源发出的光束经物镜聚焦于被测样品表面,反射光需穿过探测针孔才能被检测器接收,仅共聚焦平面的信号有效,从而获得高分辨率的三维形貌图像。该技术可实现完整晶片的无损检测,避免了机械探针法对样品的损伤,同时克服了扫描电子显微镜(SEM)仅能测量轮廓幅度的局限。
二、硅基光波导的粗糙度定义

波导加工表面粗糙度定义
在粗糙度定义方面,研究采用峰 - 谷高度(P-V)描述单次扫描的粗糙度特征,即单次扫描长度内表面起伏高度的最大差值。在此基础上,通过统计多个峰 - 谷周期的测量结果,获得均方根(RMS)粗糙度,反映表面粗糙度的整体平均水平。为实现全面表征,二维粗糙度通过在同一截面内多次线扫描的结果汇总计算得出,三维粗糙度则进一步通过选取多个横截面的测量数据综合分析获得,确保了粗糙度表征的全面性与准确性。
三、CLSM在硅基光波导粗糙度测量中的应用
研究选用共聚焦显微镜,针对 SOI(绝缘体上硅)和 SOS(氧化硅基)两种硅基光波导开展系统性测量,测量过程严格控制环境干扰与扫描精度。
1. SOI 光波导的粗糙度测量
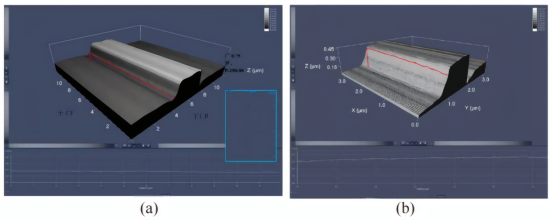
SOI光波导 CLSM 测量图:(a)和(b)分别是 SOI 波导 SWR 较小和较大的波导测试结果
采用电感耦合等离子体(ICP)刻蚀制备的脊型结构,扫描方式为沿垂直光波导方向以 100nm 间隔线扫描。在工艺控制良好的样品中,测得SOI 光波导水平与垂直方向粗糙度均为 20nm 左右,呈现各向同性分布,多次测量平均值为 20.33nm;而工艺不均匀的样品,侧壁粗糙度可达 400nm,显示出加工工艺对粗糙度的显著影响。
2. SOS 光波导的粗糙度测量

SOS光波导 CLSM 测量图:(a)和(b)分别是 SWR 水平方向分布和垂直方向分布图
测量结果显示,SOS 光波导的侧壁粗糙度呈现轻微各向异性,水平方向平均粗糙度为 29nm,垂直方向为 36nm,整体均匀性优于部分 SOI 光波导样品。为提升测量精度,实验通过优化激光半高宽参数,将测量精度控制在 10nm 以内,满足了亚纳米级粗糙度表征的需求。
四、粗糙度测量与光损耗的关联验证
将共聚焦显微镜测得的粗糙度数据代入改进的 Payne-Lacey(PL)理论模型,结合 FD-BPM 模拟,揭示二者强相关性:SOI 波导侧壁粗糙度从 20nm 增至 400nm 时,光传输损耗(OPL)从 0.8dB/cm 飙升至 5dB/cm 以上,印证粗糙度是光损耗主导因素。
耦合实验中,选取粗糙度 22nm 和 50nm 的 SOI 样品,经 F-P 腔测试,TE 模式平均光损耗 3.1dB/cm、TM 模式 4.3dB/cm,与模拟结果高度吻合,证明共聚焦显微镜测量为理论模型提供可靠支撑。此外,还发现波导宽度、硅芯折射率与粗糙度的协同效应,为波导结构优化提供关键依据。
综上,共聚焦显微镜凭借无损检测、三维高精度表征的优势,成为硅基光波导表面粗糙度测量的关键技术。其测得的精确粗糙度数据,不仅验证了改进 PL 理论模型的有效性,更明确了表面粗糙度与光损耗的量化关系。研究表明,通过共聚焦显微镜实现对光波导粗糙度的精准管控,可显著降低光损耗,为高性能硅基光波导器件的设计与制备提供重要支撑。
光子湾3D共聚焦显微镜
光子湾3D共聚焦显微镜是一款用于对各种精密器件及材料表面,可应对多样化测量场景,能够快速高效完成亚微米级形貌和表面粗糙度的精准测量任务,提供值得信赖的高质量数据。

技术支持:199-6293-0018
超宽视野范围,高精细彩色图像观察
提供粗糙度、几何轮廓、结构、频率、功能等五大分析技术
采用针孔共聚焦光学系统,高稳定性结构设计
提供调整位置、纠正、滤波、提取四大模块的数据处理功能
光子湾共聚焦显微镜以原位观察与三维成像能力,为精密测量提供表征技术支撑,助力从表面粗糙度与性能分析的精准把控,成为推动多领域技术升级的重要光学测量工具。